제품소개
Equipment 제품소개 Equipment Plating - Model UFP
Plating - Model UFP
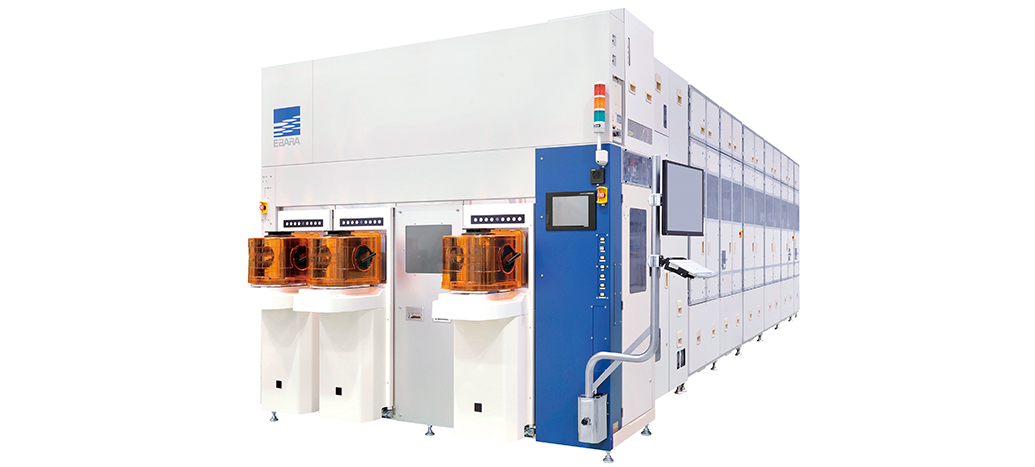
본 장비는 반도체 WLP 또는 PLP에 미세한 Pattern을 형성시키는
Clean Room 설치형의 전해 도금 장비입니다.
- Advantage
-
- 우수한 면내 균일성
- EBARA 독자의 PLP&WLP Holder사용으로 표면과 단면에 도금 석출이 없다
- 기포로 인한 비도금 현상이 없다
- 서로 다른 금속의 복합 도금처리에도 대응
- 설치 면적이 적다
- 각종 도금 프로세스에 용이하게 대응 가능
- 충실한 주변 시스템 (도금액의 공급 관리 / 납 및 시안 화합물의 무해화 처리 / 세정배수의 호수 재활용(클로즈드 시스템))
- Application
-
- Solder Bump
- Au Bump
- 동 Bump
- 니켈
- 자성막
- Specification
-
Model Solder Bump Au Bump 동 Bump 니켈 대상 WLP / PLP WLP / PLP WLP / PLP WLP / PLP 도금 막 두께(㎛) 50~100 ~25 3~125 ~25 균일 전착성(%) ±5 ±5 ±5 ±5



